미세화와 전공정 위한 차세대 퓨전 웨이퍼 본딩 장비
EV 그룹, BONDSCALE™시스템, 웨이퍼 본딩 생산성 대폭 향상
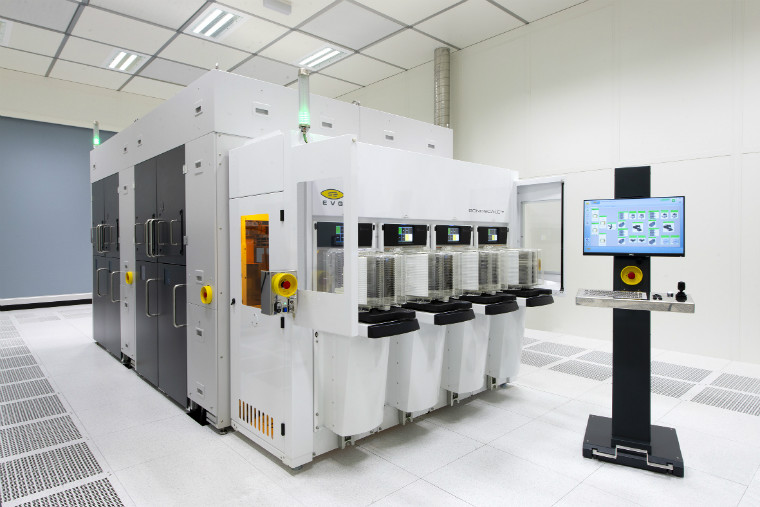
MEMS, 나노 기술, 반도체 제조용 웨이퍼 본딩 및 리소그래피 장비 분야의 선도적인 공급 업체인 EV 그룹(이하 EVG)이 완전히 새로워진 자동화 생산 퓨전 본딩 시스템인 ‘BONDSCALE™’을 출시한다고 밝혔다.
BONDSCALE은 모놀리식 3D(M3D) 같은 레이어 전이 공정 기술을 활용하는 첨단 공업용 기판 제조 및 3D 통합 방식 등 광범위한 퓨전/분자 웨이퍼 본딩 애플리케이션에 활용될 수 있도록 설계됐다.
이번 BONDSCALE 출시를 통해 EVG는 웨이퍼 본딩 기술을 프런트엔드 반도체 처리 공정에 제공함으로써, IRDS(International Roadmap for Devices and Systems)가 ‘무어의 법칙’ 이상으로 로직 디바이스를 향상시키고자 할 때의 과제들로 오래전부터 거론해 온 문제들을 해결하는 데 기여했다. 더욱 강화된 엣지 정렬 기술을 채용함으로써, BONDSCALE은 기존 퓨전 본딩 플랫폼에 비해 웨이퍼 본딩 생산성이 크게 향상됐으며 소유 비용(CoO)도 크게 낮아졌다. 고객에 대한 장비 선적은 이미 시작됐다.
BONDSCALE은 EVG의 업계 선도적인 GEMINI® FB XT 자동화 퓨전 본딩 시스템과 함께 판매되고 있으며 각각의 플랫폼은 서로 다른 용도에 초점이 맞춰져 있다. BONDSCALE은 기본적으로 첨단 공업용 기판 본딩 및 레이어 전이 공정에 주력하게 되며 GEMINI FB XT는 메모리 적층, 3D 시스템온칩(SoC), BIS CMOS 이미지 센서 적층, 다이 파티셔닝 같이 보다 높은 정렬도가 요구되는 애플리케이션을 지원할 예정이다.
EVG의 폴 린드너(Paul Lindner) CTO는 “웨이퍼 본딩 분야의 세계적인 선도기업인 EVG는 고객들이 새로운 반도체 기술을 초기 R&D 단계에서부터 최종 생산단계까지 적용할 수 있도록 하는 데 앞장서 왔다”며 “25년 전 EVG는 틈새 시장용 고주파 및 방사선 경화 방법을 디바이스 생산에 활용할 수 있는 업계 최초의 SOI(silicon-on-insulator) 웨이퍼 본딩 장비를 출시한 바 있다. 그 이후로, 우리는 고객들이 첨단 공업용 기판의 이점을 보다 폭넓은 애플리케이션에서 활용할 수 있도록 하기 위해 EVG 직접 접합 플랫폼의 성능과 CoO를 지속적으로 강화해 왔다”고 밝혔다.
또한 린드너 CTO는 “이번에 새롭게 출시한 BONDSCALE 솔루션은 한층 더 높은 수준의 생산성을 구현함으로써, 무어의 법칙 그 후의 시대를 위한 차세대 로직 및 메모리 디바이스가 지속적으로 추구하는 보다 우수한 성능, 전력 소모, 면적 축소가 가능하게 해주는 첨단 공업용 기판 및 레이어 전이 공정에 대한 증가하는 수요를 충족한다”고 덧붙였다.

